根据专利说明书,该发明提供一种用于EUV光刻的曝光成像结构、反射式光掩模版组及投影式光刻机,曝光成像结构包括第一反射式光掩模版和第二反射式光掩模版,曝光光线经第一反射式光掩模版后,将带有第一反射式光掩模版的图形信息的反射光经反射装置反射至第二反射式光掩模版,使得从第二反射式光掩模版反射的光线同时包含第一反射式掩模图形和第二反射式掩模图形的组合投影图案,以通过组合投影图案在晶圆上实现一次性曝光。
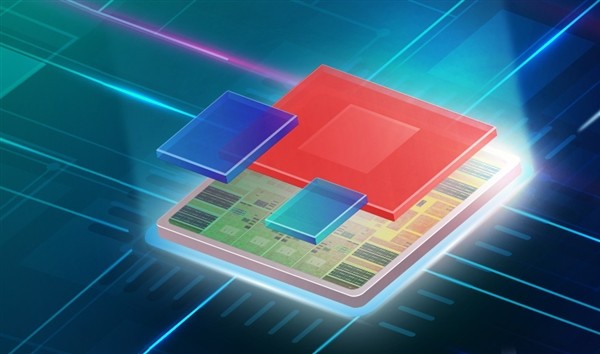
说明书介绍,这一专利曝光成像结构由于第一反射式掩模图形与第二反射式掩模图形被物理分离,可以使得相邻掩模图形边缘没有光相互作用(如散射、反射或表面等离子体激元效应SPP等),可以有效消除临近图形所造成的晶圆上的图案缺陷,光刻工艺的分辨率和对比度得到较大的提升,晶圆上的图案缺陷(如圆角、关键尺寸(CD)减少和端部内缩等)得到显著改善,同时采用一次性曝光便可在晶圆上获得完整的图案,光刻工艺的过程也得到简化。
针对EUV光源,说明书中给出的实施例显示,所述光源结构包括等离子体光源,由气体或蒸气产生,例如氙气、锂蒸气或锡蒸气,通过30千瓦功率的二氧化碳激光器每秒2次轰击雾化的锡(Sn)金属液滴(其中,锡金属液滴以每秒50000滴的速度从喷嘴内喷出),将锡(Sn)蒸发成等离子体,通过高价锡离子能级间的跃迁获得13.5nm波长的EUV光线。
 网站导航
网站导航

 相关文章
相关文章







 精彩导读
精彩导读





 热门资讯
热门资讯